專注於膠粘劑的研發製(zhì)造
底部填充膠(Underfill)作為一種重要的集成電路封裝電子膠黏劑,在先進封裝如2.5D、3D封裝中,用於緩解芯片封裝中不同材(cái)料(liào)之間熱膨脹係數不(bú)匹配帶來的應(yīng)力(lì)集中問題,進(jìn)而提高器件封裝可靠性。底部填充膠(jiāo)是一種低黏度、低溫固化的毛細管流動底部填充(chōng)料,流(liú)動速度快,工作壽命長,翻修性能佳,其在加熱的條件下可(kě)以固化,將底部空隙大麵積填滿,從而達(dá)到加固的目的,增強封裝芯片和PCBA之間的抗跌落性能。
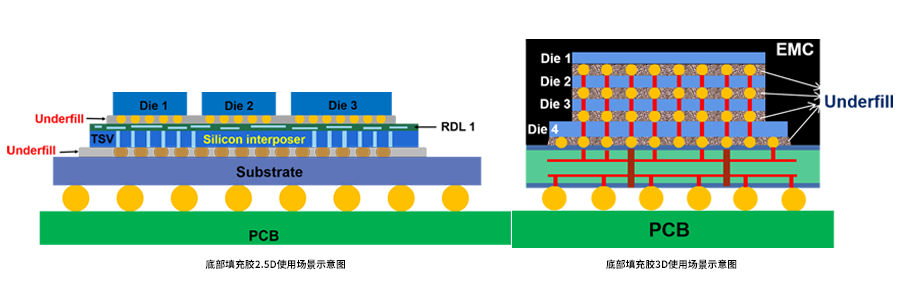
從使用場景上來看,底部填充膠分為兩種,一種是倒裝芯片底(dǐ)部填充膠(Flip-Chip Underfill),用於芯片與封裝基板互連(lián)凸點之間間隙的填充,此處的精度一般為微米級,對於底部填(tián)充膠(jiāo)提出了很高的要求,使用方一般為先進封裝企業;另一種是(焊)球(qiú)柵(shān)陣列(liè)底部填(tián)充膠(BGA Underfill),用於封裝基板與PCB印製電路(lù)板(bǎn)之間互連的焊球之間的填充,焊球之間的(de)間隙精度為毫米級(jí),對底部(bù)填充(chōng)膠要求相對較低。
一、關於底(dǐ)部填充材(cái)料
底部填充膠是由多種(zhǒng)成分組成,不同成分對材料的(de)作用不同。從工(gōng)藝角度看,較低的黏度可以縮短填充(chōng)速度,需要具備合適的固化溫度和固(gù)化時間,一般還應(yīng)易於返修;從可靠性(xìng)角度而言,底部填充膠需具備良好的填充效果以減少氣泡和空穴(xué),具備與基板(bǎn)和焊(hàn)點之間的兼容性,以及重新分配不同組件的(de)熱應力;同時需要滿足較高的表麵電阻,耐(nài)溫耐濕能力,以及耐熱(rè)衝擊能力等。
底部填充膠的性能指標主要包括以下幾個(gè)方麵:粘度(Viscosity),直接影響工(gōng)藝的填充性能(néng)和填充時間,一般底部填充膠的粘度越低,加工的效率越高;熱膨脹(zhàng)係數(CTE),因為矽芯片(2.5×10-6 /K)和印刷電路板(18×10-6 /K~24×10-6 /K)之間的熱膨脹係數差別(bié)很大,解決溫度變化(huà)產生的內應(yīng)力問題是底部填充膠發明的初衷(zhōng),應在保證其他性能的前提下盡可能減小熱膨脹係數;玻璃化轉變溫度(Tg)和彈性模量(Elastic Modulus),玻璃化轉變溫(wēn)度和彈(dàn)性模(mó)量直接影響器件的耐熱機械衝擊的能力,而這兩者對性能的影響較為(wéi)複雜且會相(xiàng)互(hù)製約,需要找到平(píng)衡點以得到合適性能的(de)產品。
底部填充膠的主體(tǐ)材料一般(bān)是環氧樹(shù)脂,通(tōng)常包含雙酚(fēn)A、雙酚F等類型的環氧(yǎng)樹脂。除去環氧樹脂,底部填充膠一般還包含填料、硬化劑、催化劑、助粘劑、阻燃劑、顏料、增韌劑和分(fèn)散劑等成分。底部填充膠所使用的填(tián)料(liào)一般為球型二氧化矽,主要為了降低熱膨脹(zhàng)係數、增強模數和降(jiàng)低吸濕性等。底部填充(chōng)膠所含(hán)成分及其功能如下圖所示,這些成(chéng)分的組合(hé)以增(zēng)強底部填充膠固化後性能為目的,大(dà)大提高了倒裝芯片封裝的可靠性。

二、底部填充工藝
倒裝芯片的底部填充工藝一(yī)般(bān)分(fèn)為三種:毛細(xì)填充(流動型)、無流動填充和模壓填充,其各自的工藝流程如下圖。一(yī)般底(dǐ)部(bù)填充工藝過程主要(yào)包(bāo)括兩個(gè)工藝,即(jí)初始底部填充工藝和隨後的固化(huà)工藝。
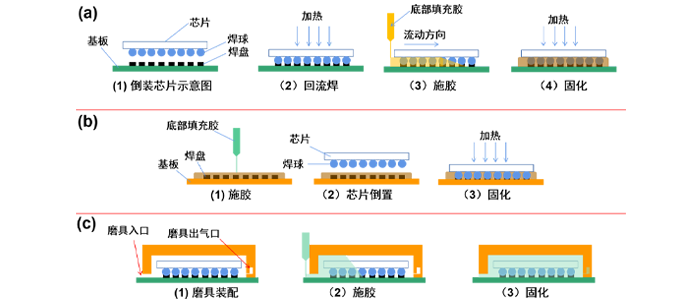
三、底部填充膠應用中常見(jiàn)問題及解決方法
1)膠粘(zhān)劑固化後會產生氣泡
氣泡一般是因為水蒸汽而導(dǎo)致,水(shuǐ)蒸氣產生的原因(yīn)有SMT(電子電路表麵組(zǔ)裝技術)數小時後會有水(shuǐ)蒸氣附在PCB板(印製電路板)上,或(huò)膠粘劑沒有充分回溫也有可能造成此(cǐ)現象。常見的解決(jué)方法(fǎ)是將電路板加熱至(zhì)110℃,烘烤一段時間後再點膠;以及使用膠粘劑之(zhī)前將(jiāng)膠粘劑(jì)充分回溫。
2)膠水滲透不到芯片底部空隙
這種情況(kuàng)屬膠水粘度問題,也可以說是選型問題(tí),膠水滲透(tòu)不進底部空(kōng)隙,隻有(yǒu)重新選擇(zé)合適的產品,專業廠家(jiā)底部填充膠(jiāo),流動性好,在毛細作用下,對BGA封裝模式(shì)的芯片進行底部填充,再利用加熱的固(gù)化(huà)形式(shì),快達3-5分鍾(zhōng)完(wán)全固化,將BGA底部空(kōng)隙大麵積填滿(mǎn)(填(tián)充飽滿度達到95%以上),形成一致和無缺陷的底部填充層(céng),並且適合高速噴膠、全自動化批量生產,幫助客戶提高(gāo)生產效率,大幅縮減成本。
3)膠水不完全固化或不固(gù)化
助焊劑殘留會蓋住焊點的裂縫(féng),導致產品失效的原因檢查不出來,這時要先清洗殘留的助焊劑。但是芯片焊接後,不能保證助焊劑被徹底清除。底部填充膠中的成分(fèn)可(kě)能與助焊劑殘留物反應(yīng),可能發生膠水延遲固化或不固化的情況。要(yào)解(jiě)決由助(zhù)焊劑影響底部填充(chōng)膠能否固化的問題,首先要防止助焊劑(jì)的殘留,以及要了解膠水與助焊劑的兼容性知識,底部填充膠具有工藝簡單、優(yōu)異的助焊劑兼容性、毛(máo)細流動性、高可靠性邊角補強粘合等特點,並(bìng)且專業廠家可以全(quán)方位(wèi)提供用膠方案,有效解決此問題。

四、研泰化學專業(yè)研發生產底部填充膠
在倒裝芯片封裝(zhuāng)中,矽芯片使用焊接凸塊而非焊線直接固(gù)定(dìng)在基材上,提供密集的互連,具有很高的電氣性能和熱性能,倒裝芯片互連實現了終極的微型化,減少了(le)封(fēng)裝寄生效應,並且實現了其(qí)他傳統封裝方法無法實現的芯片功率分配和地線分配新模式。研泰化學技術團隊根據累積經驗(yàn)案例創新研發的MX-62係列底部填充(chōng)膠,從搭載無源元器件(jiàn)的大型單芯片封(fēng)裝,到模塊和複(fù)雜的先進 3D 封裝,包含底填CUF封裝膠(jiāo)水(shuǐ)、液態塑封料LMC底部填充膠水、顯示模組COF用(yòng)底填封裝膠水以及多種不同的低成本創新(xīn)選項,研泰化學能提供豐富的倒裝芯片(piàn)底(dǐ)部填充膠水產品組合解決方案。

總而言之,底部填充膠是增強BGA組(zǔ)裝可靠性的重要輔料,選擇底部填充(chōng)膠的好壞對產品(pǐn)可靠性有很大影(yǐng)響。如(rú)何選擇與評估至關重要.研泰化學深耕電子膠粘劑行業十餘載,研發(fā)的MX-62係列底部填充膠具有良好的耐冷熱衝擊、絕緣、抗跌落、低吸(xī)濕、低線性熱膨脹係數、低粘度、流動性好、可返修等性(xìng)能,廣泛應用於通訊設備(bèi)、儀(yí)器儀表、數碼電子、汽車電(diàn)子、家(jiā)用電器、安防器械等行業。如您遇到電子行業用膠難題(tí),例如為什麽底部填充膠出現氣隙等,歡迎通過在線客服、網(wǎng)站留言、來電、郵件等(děng)方式聯係www.5555香蕉.com,研泰化學有專門的技(jì)術團隊為您解決問題,將第一時間響應您的需求。